原理
超高真空下で試料に一次イオンビームを照射すると、試料の極表面(1~3nm)から二次イオンが放出される。二次イオンを飛行時間型(TOF型)質量分析計へ導入することで、試料最表面の質量スペクトルが得られる。この際に一次イオン照射量を低く抑えることにより、表面成分を化学構造を保った分子イオンや部分的に開裂したフラグメントとして検出することができ、最表面の元素組成や化学構造の情報が得られる。
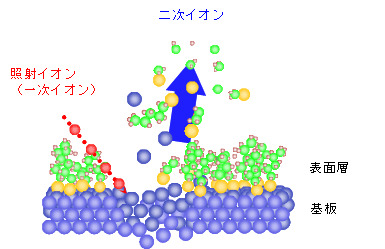
飛行時間型(TOF型)質量分析計
パルス化された一次イオンの照射で発生した二次イオンは一定のエネルギーで加速され、質量に応じた速度で(軽いイオンは高速、重いイオンは低速)質量分析計に入る。検出器に到達するまでの時間(飛行時間)は質量の関数であり、この飛行時間の分布を精密に計測することによって質量スペクトルが得られる。
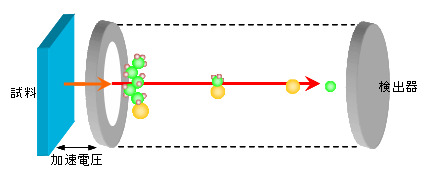
その他表面分析の原理