収差補正機能とは
近年の透過電子顕微鏡(TEM)の進歩は目覚ましいものがあるが、その最たるものが収差補正技術の開発である。電子顕微鏡に用いられる磁場レンズは、原理的に凸レンズしか作ることができないため、光学顕微鏡のように凹レンズとの組み合わせでレンズ収差を改善することができない。そのため、レンズの各種収差、特に3次の球面収差(Cs)の影響により、分解能が制限されていた。しかし近年、以前より理論的に提唱されていた多極子によって凹レンズを実現する装置が、電気的安定性の向上や制御に必要な実験データの蓄積等により実用化された。この球面収差補正機構がTEMの照射系や結像系に組み込まれることによって、従来の加速電圧200kVのTEMでは実現できなかった0.1nm分解能が達成され、単原子レベルでの位置特定や元素の識別が可能となった。
Fig.1に、照射系で収差補正機構の有無による電子線の経路図の違いを示す。レンズの中心から離れた場所を通った電子線は、より大きく屈折されるため、通常は電子線が試料面上で一点に収束せず、電子プローブサイズが拡がってしまう。一方、凸レンズの上方に凹レンズ(収差補正機構)を導入すると、この屈折量の差をうまく打ち消すことができる。したがって電子線を試料面上でより局所的な領域に収束でき、細い電子プローブが形成できる。
また収差を補正することにより、レンズの中心から離れた高角度の電子線を利用できるため、大きなコンデンサー(集束)レンズ絞りを使用できるようになる。通常、コンデンサーレンズ絞りは10mrad程度までしか用いることはできないが、収差補正により20~40mradの大きなコンデンサーレンズ絞りを用いることができる。Fig. 2で示したように、収差補正前に比べて収差補正後の電子プローブの電流値は1桁程度増大する。
Fig.1 電子銃から試料表面までの電子線の経路図
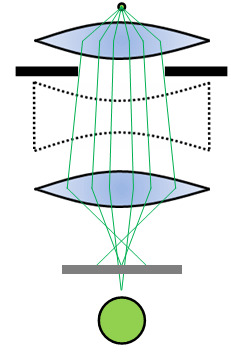
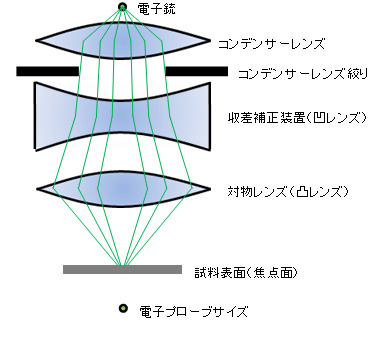
Fig.2 電子プローブの強度プロファイル



収差補正プローブを用いた超高分解能STEM観察
走査透過型電子顕微鏡(STEM)像の分解能は試料に照射する電子プローブのサイズに依存する。電子線をプローブ状に収束させる役割を果たす対物レンズの収差を補正することにより、従来よりも細い電子プローブを形成でき、0.1nm以下の超高空間分解能STEM観察が実現される。また収差を補正することにより、レンズの中心からの距離が長い電子線も利用できるようになるため、電子プローブの強度が大幅に増大する。そのため収差補正前に比べて1/10程度の短時間で低ノイズなSTEM像を取得でき、試料ドリフトの影響を軽減できる。
Fig.1はシリコン単結晶を<110>方向から観察した収差補正前後の高角環状暗視野STEM(HAADF-STEM)像である。収差補正前の像は間隔0.136nmのシリコン原子列同士(シリコンダンベル)が一つの輝点(楕円)としてしか観察されないが、収差補正後の像はこれらの原子列を分離して観察することができている。また収差補正前は長い像取得時間が必要なため、試料ドリフトの影響により黄色の点線で示したシリコンの原子面同士が直交していない。これに対して収差補正後は短時間で像を取得できるため、黄色の点線同士がほぼ直行しており、実際の結晶構造からのずれが抑制されている。
Fig.1 シリコン単結晶を方向から観察したHAADF-STEM像
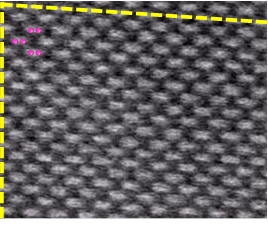
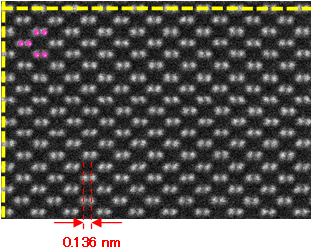
Cold-FEGを用いた高エネルギー分解能EELS測定
電子源から放出される各々の電子が持つエネルギーの値は僅かに揺らいでいる。さらには、高圧やレンズ系など装置の安定性によっても変動が加わることで、入射電子線のエネルギー分布は、EELSスペクトルのエネルギー分解能の低下をもたらす。近年の安定度を増した装置系においては、電子エネルギーの揺らぎは電子源の種類に大きく左右される。大多数の電子顕微鏡に搭載されているショットキー型電界放射電子銃(Schottky-FEG)は使用時にフィラメントを高温加熱しなければならないが、冷陰極型電界放射電子銃(Cold-FEG)は常温で動作するため、電子エネルギーの熱揺らぎが小さくなる。その結果、Cold-FEG使用時の入射電子線のエネルギー分布の半値幅(FWHM)は、Schottky-FEG 使用時の半分以下の0.35eV程度となる。
Fig.1は構造や組成の異なる様々な酸化チタンと実験で得られた酸化チタンのTi-L吸収端近傍のEELSスペクトルである。Cold-FEGを使用することでEELSのエネルギー分解能が向上し、各ピークの位置や形状を詳細に比較することが可能となっている。実験で得られたEELSスペクトルはルチル型のTiO2のEELSスペクトルと良い一致を示しており、測定試料がルチル型のTiO2であると特定できる。
Fig.1 様々な構造や組成の酸化チタンのTi-L吸収端近傍スペクトル
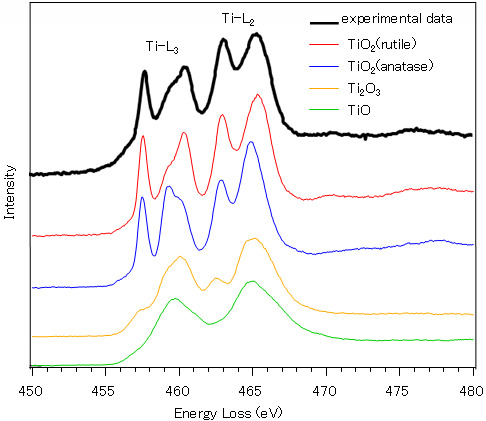
大口径SDD検出器を用いた高感度EDX測定
EDXの検出器として従来はSi(Li拡散)型半導体検出器(Solid State Detector: SSD)が用いられてきた。近年開発されたシリコンドリフト検出器(Silicon Drift Detector: SDD)は、検出器に入射した特性X線によって検出器内で発生した電子に同心円状の電位勾配をかけることにより、効率良くアノードに導くようにした検出器である。SDD検出器は、SSD検出器と比較して10倍以上の検出効率を有する。またEDX検出器の窓の面積が大きいほど検出効率が向上する。今回導入した装置に搭載されているSDD検出器は有効口径が100mm2と従来の3~4倍程度大きく、高感度なEDX測定が可能である。
Fig.1はSSD検出器及びSDD検出器を用いて取得されたNMOSゲート部の2次元組成分析マッピングの比較である。SDD検出器を用いた場合、SSD検出器の1/10の測定時間でほぼ同程度S/N比のデータが得られている。さらには、特に低エネルギー領域における分解能が向上したことにより、軽元素であるC、N、Oなども明瞭に確認できる。
Fig.1 NMOSゲート部の2次元組成分析マッピング
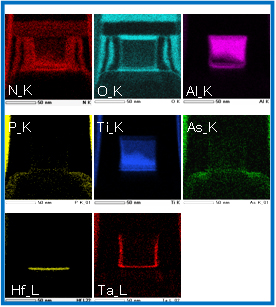
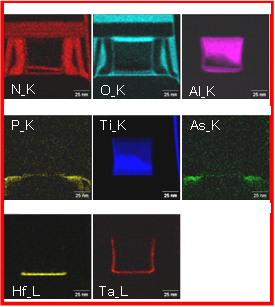
低加速電圧によるカーボン材料などの低ダメージ測定
カーボンナノチューブやグラフェンに代表されるカーボンナノ材料や有機材料などは、入射電子が試料中の原子を直接たたき出すノックオンダメージを受けやすく、通常用いられる加速電圧200kVで明瞭な構造観察や組成分析を実施することは困難であった。80kVの低加速電圧でこれらの材料を観察することによって、電子線照射によるノックオンダメージを抑制した測定が可能になる。
Fig.1(a)及び(b)はそれぞれ加速電圧80kVで撮影した2層カーボンナノチューブの明視野STEM像及びHAADF-STEM像である。電子線照射による試料の損傷が抑えられたことにより、カーボンナノチューブの炭素原子の原子配列を明瞭に観察することに成功している。Fig.1(c)はFig.1(b)に示した測定点A(外側の層)、B(内側の層)、C(ナノチューブの中央)から取得したEELSスペクトルである。測定点ごとに異なる形状のスペクトルが取得できており、炭素原子の局所的な電子状態の議論が可能となる。
Fig.1 80kVの低加速電圧で測定した2層カーボンナノチューブの測定結果

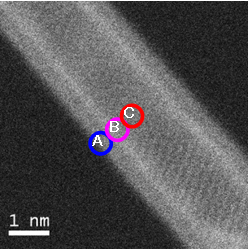
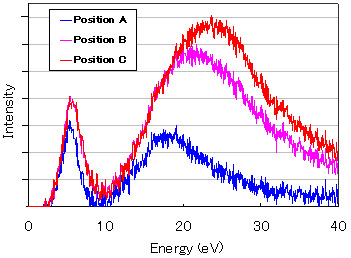
その他形態観察の分析の原理