導入装置一覧
-
最新鋭ダイナミックSIMS“NanoSIMS 50L”を導入しました
2018.11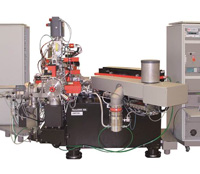
最新鋭ダイナミックSIMS“NanoSIMS 50L”を導入しました。本装置では、プローブ径約50nmのイオンビームと、透過率の高い質量分析系の併用により、従来のSIMSに比べて格段に小さな領域において、高い検出感度でイメージング分析を行うことが可能です。また深さ方向に分析することにより、3Dイメージングやデプスプロファイル測定も可能です。半導体やセラミックスからライフイノベーション分野に至る様々なフィールドにおける活用を考えております。
-
MS/MS機能付きTOF-SIMS装置を導入しました
2017.06
最新鋭TOF-SIMS(MS/MS機能付き)装置を導入しました。本装置のMS/MS測定により、多成分系でも単一成分の質量スペクトルを分離可能であり、従来より解析精度が飛躍的に向上しました。最表面の特定微小領域のMS/MS測定、MS/MSマッピング測定のほか、ガスクラスターイオンビーム(GCIB)エッチングを併用することで深さ方向のMS/MS測定が可能です。高感度な微量有機分析手法として、有機ELディスプレイ、蓄電材料、各種ポリマーなどの多岐にわたる分野に適用することができます。また、MS/MS機能以外にも、冷却測定機能や、凹凸のある試料でも形状の影響を低減したマッピングが得られるなどの新規機能も搭載しております。
-
グロー放電質量分析装置を導入しました
2015.12
グロー放電質量分析(GD-MS)装置を導入しました。本装置は、固体無機材料(粉体含む)における不純物の全元素半定量分析(約70元素の一斉分析)が可能です。従来の装置に比べて放電電流が高いためスパッタ速度が速く、100μm程度のデプスプロファイル分析も可能です。また、新機能としてパルスモード(DC電圧をマイクロ秒パルスにカット)を用いることで非導電性試料のバルク分析や薄膜のデプスプロファイル分析も可能です。適用分野はSi, SiC,セラミックス原料, 金属などのバルク分析、導電性基板のデプスプロファイル分析が挙げられます。
-
超音波映像装置を導入しました
2012.10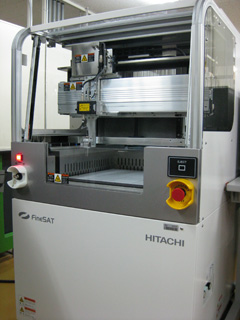
超音波映像装置(SAT)を導入しました。同手法は、固体内部を非破壊で観察できる数少ない手法であり、特に剥離やボイド、クラックなどの欠陥の検出に有効です。導入装置は300mm□程度の大型試料を無加工で測定できるという特長を有しています。また、超音波プローブも幅広く取り揃えており、最高でμmオーダーの高分解能観察が可能です。観察対象は、半導体パッケージやウェハ、工業材料など広範囲に適用可能です。
その他にも、曲げ試験とSATを組み合わせた当社独自の観察メニューをご用意しております。 -
GCIB搭載TOF-SIMS を導入しました
2016.09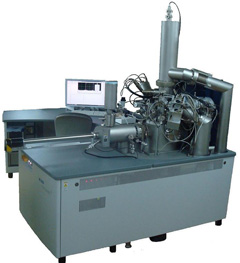
ガスクラスターイオンビーム:GCIB(Ar2500+)により、画期的な有機分子の深さ方向解析が実現!
有機物のデプスプロファイルにおいて、従来のCs+, O2+, Ar+などのイオンビームでは、有機物が分解されたダメージ層が蓄積されますが、GCIB(高質量のクラスターイオンビーム)によりダメージを極端に抑えたデプスプロファイル測定ができます。さらに、精密斜め切削法/TOF-SIMSよりも安定した深さ方向分析が可能となります。新装置の主な特徴
ガスクラスターイオン(Ar2500+)銃の搭載
1~8 eV / atomの低エネルギーで有機物をダメージレスエッチング
新型1次イオン源(Bi NANOPROBE)を搭載
空間分解能が従来よりも向上!
(従来) 300 nm → (新装置) <100 nm応用
・有機薄膜中における微量有機成分の深さ方向分析
・有機積層膜(OLED, 有機薄膜太陽電池など)の組成分析
・界面の化学構造、微量成分(汚染など)の分析 -
水銀プローブ方式C-V測定装置を導入しました
2013.12
試料面に電極を形成する必要がなく、高感度、高精度で、面内マッピングが可能な水銀プローブ方式C-V測定装置を導入しました。本装置を用いると、半導体デバイス用薄膜(特に絶縁膜)に関する諸特性(誘電率、絶縁膜中電荷の評価(Vfb)、C-V特性、I-V特性、界面準位(Dit)、キャリアライフタイム、エピタキシャル層の抵抗率、ドーパント量の評価、絶縁試験(TZDB、TDDB)など)を評価することが可能です(最大8インチサイズのウェハまで、ウェハ以外の形状でも対応可)。各種プロセスで作製した絶縁膜評価を低コストで迅速に行いたいという、ご希望があれば、是非一度お試しください。
-
高周波グロー放電発光分析装置を導入しました
2013.03
高周波グロー放電発光分析装置(GD-OES:Glow Discharge Optical Emission Spectroscopy)を導入しました。本装置は、ダイナミック(D-)SIMSと比較して、高速に3 nm~100 µm程度の深さ方向分解能の高いデータを取得できるという特徴を有しています。また、分析可能な濃度域も数10 ppm程度の不純物レベルから主成分レベルまで幅広く対応しております。適用例としましては、D-SIMSの適用例がなかった、あるいは少なかった非半導体分野を中心に、各種電池電極材料・ポリマー材料・セラミックス材料・半導体材料など、非常に幅広い分野でご活用頂ける分析手法となっております。
保有機能
| 得られる情報 | 手法、機能 | 独自メニュー、強み |
|---|---|---|
| 深さ方向 不純物分布 |
SIMS | Backside SIMS、軽元素高感度分析化合物半導体組成分析、微小領域分析 (TOF-depth)、Cryo-SIMMS |
| GD-MS | パルス機能によるデプス | |
| 深さ方向組成分析 | RBS/HFS、NRA、PIXE | 水素を含む、薄膜主成分の高精度定量 |
| 深さ分布 | GD-OES | 有機/無機ハイブリッド膜分析 |
| 表面化学構造 | TOF-SIMS | データベースによる解析力、 各種材料の経験、MS/MS、冷却測定 |
| 深さ方向 化学構造分布 |
GCIB-TOF-SIMS | |
| 表面組成化学状態 | XPS | 気相化学修飾法、 GCIBガンによる表面クリーニング、HAXPES |
| 局所深さ分布 | AES | 高空間分解能 |
| 極表面の元素付着量 | LEIS | 酸素原子クリーニングによる汚染除去、シミュレーションによる厚さ評価 |
| 化学状態、原子間距離 | XAFS | in situ 分析、STXMによるマッピング |
| 表面加工 | イオン注入 | 広範囲な元素に対応 |
| 半導体の電気特性 | 水銀プローブ | 化合物半導体のキャリア分析など |