サービス内容(反り・変形・たわみの評価)
- 薄型基板/異種材料積層基板/半導体パッケージ/電子部品の反り測定
- 実装加熱・リフロー中の反り挙動を温度プロファイルで可視化
- 特定エリアの反り測定(切出し解析、局所評価)
- 水平方向/垂直方向/対角方向の反り毎に、反り量ばらつき解析
- 反った基板と部品(BGA等)のGap解析
- パターン残銅率と反りの相関解析、反り断面解析、形状三次元(左右対称性、ねじれ 等)
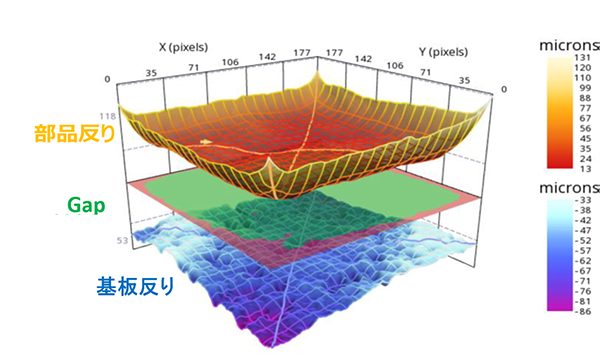
反った基板と部品のGap解析

シャドウモアレ反り測定器
反り測定と改善のサイクル(実装・リフロー工程を想定)
- 実装・リフロー温度プロファイルを想定した反り測定
- 材料・構造・残銅率・熱履歴など、変形/たわみ要因の解析
- 反り起因のリスク予測と、反り低減のための条件を分析
- 条件変更後の再測定による最適化

反り測定と改善のサイクル
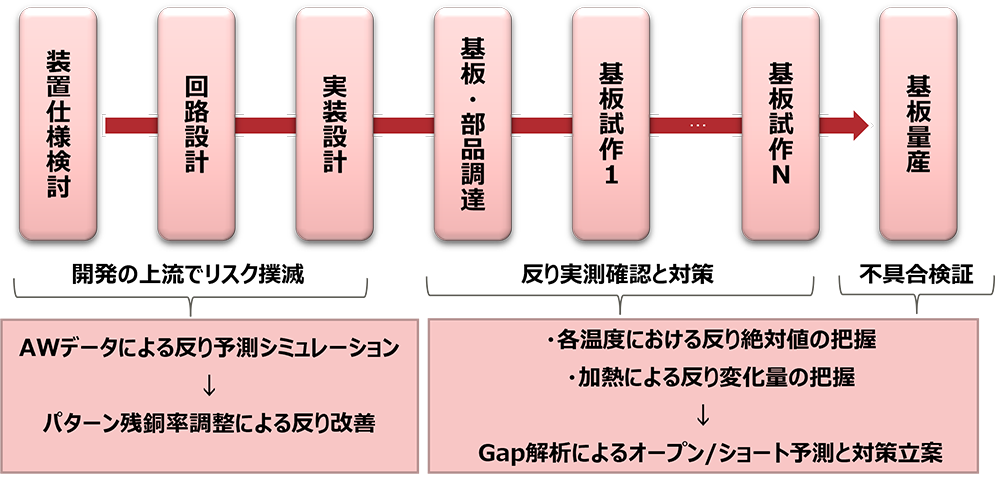
各ステージにてリスク予測と改善提案
特徴・効果
規格準拠の反り測定
IEC 60191-6-19、JEITA ED-7306に準拠したシャドーモアレ方式で反りを評価します。
リフロー中の反り・変形を可視化
室温~Max.300℃から室温の反り挙動を温度依存で捉え、変形・たわみの発生タイミングまで追跡します。
パッケージ/部品とのGap解析
BGAパッケージや部品実装時のGap量に応じ、ショート/オープンを防止する最適な施策を提案します。
不良ゼロに向けた最適化支援
基板材料構成・設計からはんだ量・温度プロファイル条件まで、多角的に解決方法を提案します。
実績(対象分野)
- ウェアラブル機器、スマートフォン、ノートPCなどのポータブル機器
- 大型、小型通信機器、電子制御ユニット
- 車載機器
- 各種装置の実装基板ユニット
測定事例
- 基板の加熱時反り測定/部品搭載部の切出し反り測定
- リフロー加熱によるBGAパッケージの反り・変形・たわみ挙動測定
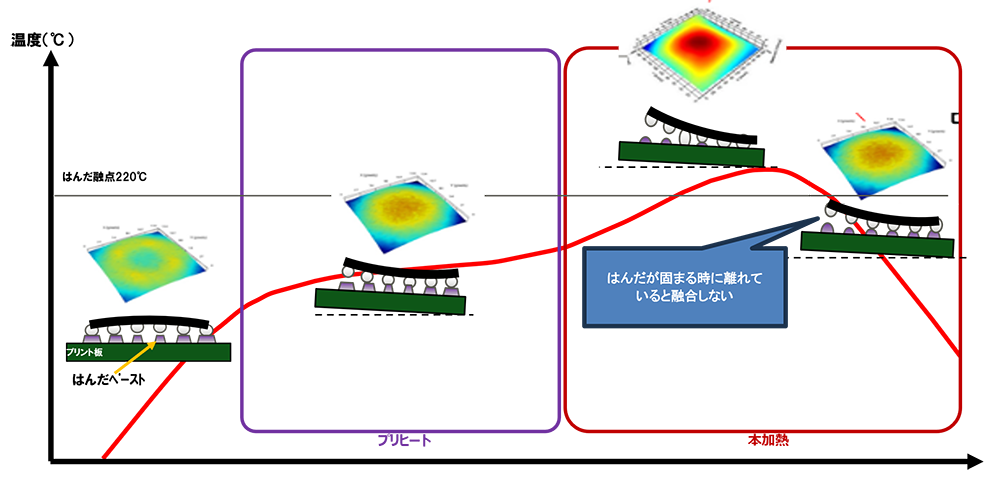
基板の加熱時反り測定 部品搭載部分切り出し反り測定事例
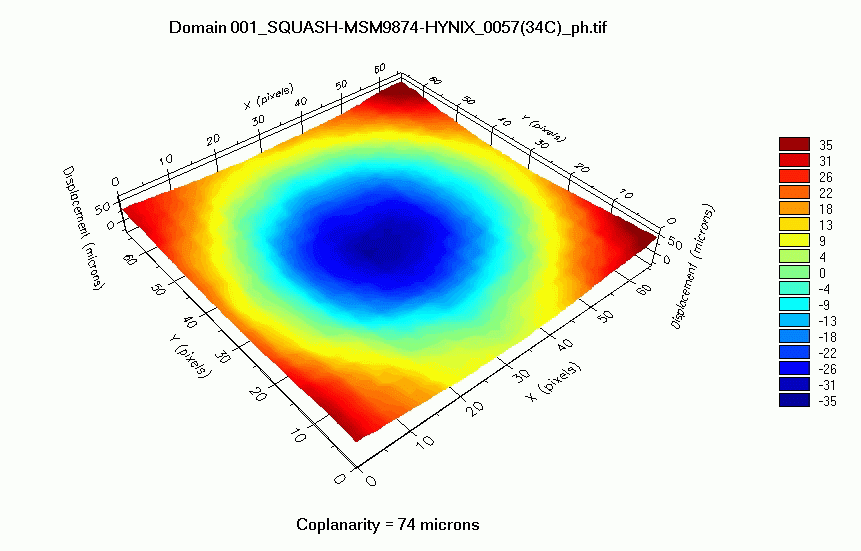
リフロー中の加熱によるBGAの反り挙動
関連測定サービス
- 触診式反り形状測定
- レーザ非接触式反り形状測定
- プロジェクションモアレ式反り測定
- デジタル画像相関法(DIC)解析
よくあるご質問(反り・実装・リフロー)
- Q:BGA以外の部品も反り測定が可能ですか?
A:はい、LGAやQFN/底面電極部品、モジュール部品も測定可能ですので、ご相談ください。 - Q:セラミックやガラス、板金等の材料単体の反りも測定できますか?
A:はい、600mm×600mm以下であれば、測定可能な場合が多いですので、ご相談ください。 - Q:リフローに一度通した後に、反り測定可能でしょうか?
A:はい。リフローだけでなく、恒温槽によるベーキング等も可能です。