各種工業材料、エレクトロニクス製品において、製造工程中や使用中に発生する応力・歪みは、製品の故障、不良、劣化等の原因になります。そのため、故障や不良が発生した場合、応力・歪みがその原因とされることが多くなってきています。しかし、応力・歪みは目には見えないため、何らかの方法で数値化、可視化することが必要です。
応力・歪みを測定できる手法は下表に示すとおりたくさんありますが、どんなものにも適用できる手法はありません。したがって、対象物に適した分析手法を選択することが重要です。また、応力・歪みは材料、製品の「状態」を表す値であるため、状態をできるだけ変えないように測定することも重要になってきます。
当社では、永年培ってきた高度な技術と経験を踏まえ、対象物に最適の分析手法をご提案し、お客さまの問題解決のお手伝いをさせていただきます。
応力・歪み解析に用いる手法
| 手法 | 対象材料 | 特長 |
|---|---|---|
| X線回折 | 結晶 | 非破壊、高感度 |
| 歪みゲージ | 実装品、各種構造体 | 高感度、簡便 |
| ウェハ反り | 各種ウェハ | 高感度、簡便 |
| 顕微ラマン | 半導体、セラミックス、炭素材料等 | 非破壊、高感度 |
| ルミネッセンス(蛍光) | 半導体、セラミックス、 発光材料等 | 非破壊 |
| 光弾性 | ガラス、透明樹脂等 | 2次元分布 |
| nED (NBD) | 結晶 | 極微小領域 |
| CBED | 結晶 | 極微小領域 |
| RBS | 結晶 | チャネリング現象利用 |
| EBSD | 結晶 | 非破壊、高空間分解能 |
Si基板上ZrO2薄膜の残留応力
各種エレクトロニクス材料の薄膜における残留応力は、膜の剥がれや割れなどを引き起こす原因のひとつとなり得る。ここでは、強誘電体薄膜として使用されるSi基板上のZrO2(膜厚60nm)の残留応力を測定した。
1) X線回折を用いた応力算出方法
試料面内に残留応力が生じている場合、ある指数の格子面の面間隔dは、格子面と応力方向の間の角度により変化する。試料のあおり角Ψを変えることで、試料面に対して傾いた格子面を測定することができるため、試料面内に働く残留応力を評価することができる。

2) 測定例 : Si基板上ZrO2薄膜(膜厚60nm)
Ψ角が大きくなるにつれ、ZrO2の2θ位置が低角側にシフトしている(d値が大きくなっている)ことがわかる(下左図)。2θ-sin2Ψプロット(下右図)の傾きから応力値を求めた。
粉末試料と比較して、薄膜での残留応力は、非常に大きい引張りの残留応力が働いていることがわかった(上表)。
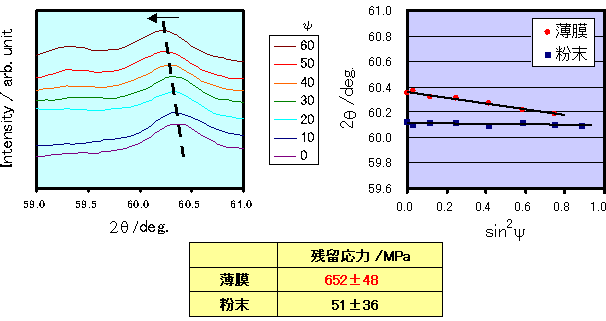
歪みゲージを用いた実装部品の熱変形挙動評価
半導体実装部品は、封止樹脂、Siチップ、基板など弾性率、熱膨張係数の異なる材料で構成されているので、昇降温時に各構成材料の弾性率、熱膨張率のミスマッチにより熱応力が発生しやすく、このためSiチップ、基板等に反りが発生することがある。したがって、実装部品の熱変形挙動を把握することは非常に重要である。ここでは、実装部品に歪みゲージを貼り付け、各部位の熱変形挙動を測定した例を紹介する。
歪みゲージとは

被測定物の表面に貼り付けて微小変形を測定するセンサ
↓
金属箔の抵抗素子が変形したときの電気抵抗変化を歪みに換算
高感度:1mの長さの材料が1mm変形したときの歪み検出が可能
材料の弾性率、ポアソン比、線膨張率の測定に使用
[長所]
- 実製品形状のままで測定可能
- 裏表面、多方向に貼付 ⇒ 局所的な反り、変形挙動の情報取得が可能
- 凝固、硬化時の変形挙動の解析に適用可
[短所]
- 測定面積が1mm×1mm以上必要
- 測定温度範囲に制限(~250℃)
- 細い/薄い/柔らかい試料には不適
2) Siチップと基板の積層材料における熱変形挙動
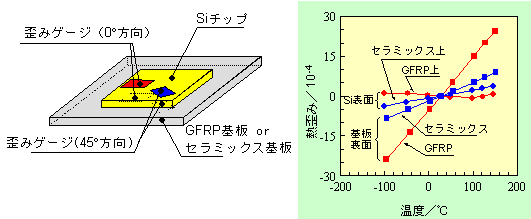
- セラミックス基板上のSiチップ表面の方が温度変化による歪み発生量が顕著
- GFRP基板上のSiチップ表面は温度上昇とともに収縮。基板のガラス転移温度を超えた温度域から膨張に転じる。
薄膜 / ウェハの反りによる応力測定
ウェハ上に薄膜を成膜すると、ウェハと薄膜の熱膨張率差により反りが生じる。この反り量(曲率半径)から下式により薄膜の応力を求める。応力の算出に、ウェハの厚さ、弾性率、ポアソン比と、膜厚が必要である。応力の温度依存性を求めることが可能である。
測定原理図
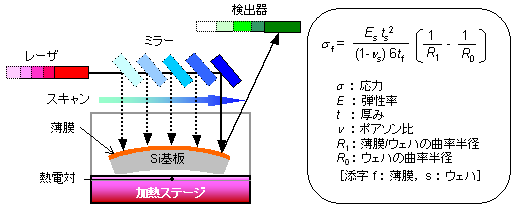
測定例
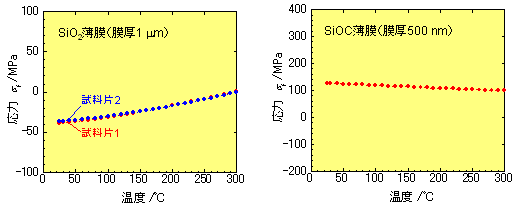
SiO2薄膜の応力は、室温では負(引っ張り)であるが、温度の上昇とともに低下している。
一方、SiOC薄膜の応力は、室温では正(圧縮)を示し、温度の上昇とともにSiO2薄膜同様、低下していることがわかる。
ラマン分光法を用いた局所応力評価
ウェハ上に薄膜を成膜すると、ウェハと薄膜の熱膨張率差により反りが生じる。この反り量(曲率半径)から下式により薄膜の応力を求める。応力の算出に、ウェハの厚さ、弾性率、ポアソン比と、膜厚が必要である。応力の温度依存性を求めることが可能である。
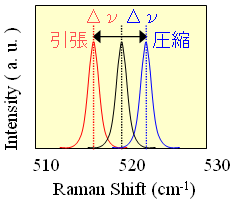
ラマン分光法は、光の非弾性散乱現象を用いた分光法であり、物質の振動状態に関する情報を得ることができる。半導体、セラミックス等の応力を高空間分解能、高感度で評価することができる。
結晶に応力が加わると原子間距離が変化する。一般に、原子間の結合力は原子間距離の関数であるので、原子間距離に応じて結合力は変化する。したがって、応力により格子振動(フォノン)の振動数が変化する。一般に、圧縮応力が生じるとフォノン線が高波数側にシフトし、引張り応力が生じると低波数側にシフトする。
ラマン分光法を用いた基板研削ダメージ評価
表面を研削加工したSiウェハに生じる残留応力の深さ依存性を測定した。
表面近傍は、圧縮応力が生じ、深さ方向に応力が緩和されている様子が観測された。

BaTiO3の応力評価
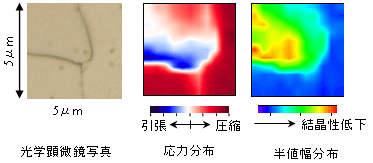
BaTiO3の単結晶について、クラック近傍の応力評価を行った。
クラックを境に引張り応力から圧縮応力に変化している。
また、ラマン線の半値幅は結晶性の指標となり、半値幅の大きな場所では結晶性が低下しているものと考えられる。
nED(NBD)*を用いた局所歪み評価
* nED:nano Electron Diffraction, NBD:Nano Beam Diffraction
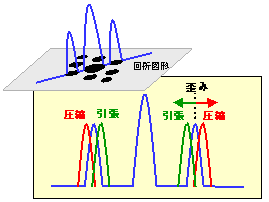
近年、半導体デバイスは更なる高集積化、高速化、小型化への一途を辿っている。サブミクロン程度にまで微細化した素子を高密度にて集積化する製造工程内において、局所的な応力や欠陥が発生し、素子特性や耐久性に大きな影響を及ぼすことが懸念されている。このような局所領域における歪みをTEM-nED(NBD)で評価することが可能である。
<特長>
TEMを利用したナノレベル領域での歪み測定
0.2%程度の格子間隔変化を検出
デジタル化による短時間での高精度評価
シリコントレンチ近傍の応力評価
図2は測定に用いたトレンチの概略モデルである。図3は微小領域から得られた極微電子線回折図形、極微電子線回折図形における(002)回折強度分布である。基準点におけるスペクトルと比較して、(002)回折ピーク位置が僅かにシフトしており、解析から基板底部では基板垂直方向(001)に0.5%程度圧縮していることがわかる。トレンチ周辺付近の評価結果を図4にまとめた。トレンチ周辺付近では、作製工程中に生じた応力により格子歪みが生じているものと考えられる。このように、TEM-nEDでは、さまざまなデバイス材料について僅かな歪みを評価することが可能である。
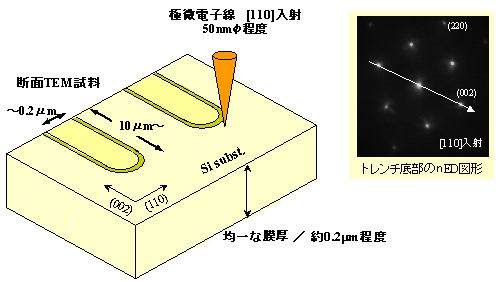
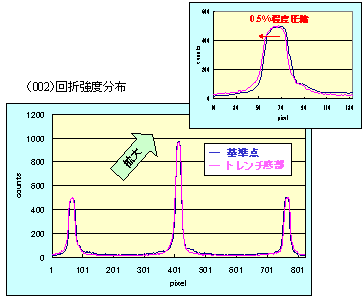
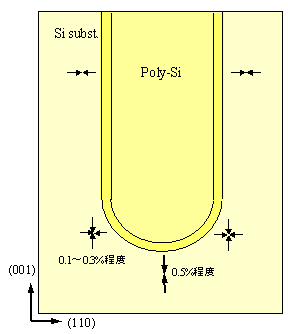
・トレンチ底部では
基板垂直方向(001)に0.5%程度圧縮
・トレンチ周辺部では僅かな圧縮応力
↓
トレンチ周辺付近では、作製工程中に生じた応力により格子歪み(圧縮)が生じている。
nED(NBD)により、微小領域での歪み評価が可能