原理
半導体中の電気的に活性化したキャリアの深さ方向濃度プロファイルを測定する方法である。試料を斜め研磨し、研磨面に2探針を接触させ、そのプローブ間の拡がり抵抗を測定する。得られた拡がり抵抗から較正曲線を用いて比抵抗を算出する。また、既存のキャリア移動度を用いて基板に対する比抵抗-キャリア濃度の関係に従いキャリア濃度を得る。

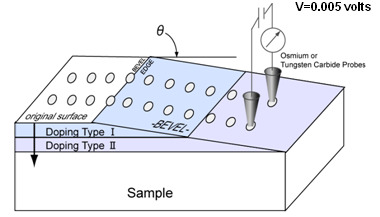
- 数mm角の領域から50×100μm程度のパターン領域の分析が可能。
- キャリア濃度は1E13~1E20cm-3、深さは100nm~mmまで可能。
- 適切な研磨角度を選択することにより、極浅接合から深い接合まで、様々な範囲でのキャリア濃度分布を調べることができる。
- SIMS分析と組合わせることで、ドーパントがどの程度活性化しているかの評価も可能。

本手法は、米国Solecon Laboratories社への再委託(外注)となります
その他表面分析の原理