素子の微細化に伴い、デバイスには従来には考えられなかった様々な課題・問題が発生している。また、それらを克服するには、製造プロセスの最適化が不可欠である。以下にデバイスの主な問題点・着目点と各製造プロセスでの評価項目を示す。
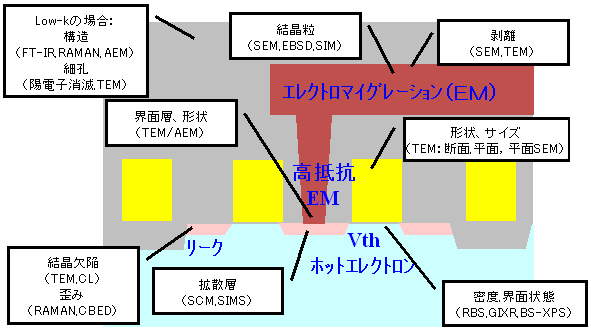
製造プロセスと評価項目
| プロセス | 評価項目 | |
|---|---|---|
| 洗浄 | 清浄度、薬液残渣(しみ) | |
| 酸化・拡散 | 酸化膜厚、不純物、欠陥、キャリア濃度分布、シート抵抗 | |
| イオン注入 | ドーパント分布、表面汚染、コンタミネーション、欠陥、 スラリー残渣、メタル残渣、平坦性 |
|
| CMP | ||
| エッチング | 変質層・ダメージ層、形状、残渣・汚染 | |
| リソグラフィー | (リソグラフィー分析メニュー) | |
| 成膜 (CVD、PVD) |
眉間絶縁膜 (low-k) |
組成、細孔径分布、密度、密着性 |
| ゲート絶縁膜 (high-k) |
膜厚、組成、密度、結晶性 | |
| Poly-Si | 結晶粒径、キャリア・ドーパント濃度分布、不純物 | |
| バリアメタル | カバレッジ | |
| 配線 | 結晶粒径、不純物、ボイド | |
| SiN、TEOS など |
組成、不純物、ウェハのそり・応力 | |
分析メニュー
| 評価項目 | 分析法 |
|---|---|
| 応力・歪・そり | Raman |
| X線回折 | |
| TEM | |
| NBD、CBED | |
| 歪ゲージ | |
| 組成・化学状態 | XPS |
| AES | |
| FT-IR | |
| RBS | |
| SIMS | |
| 蛍光X線、EPMA | |
| TEM-EDX、EELS | |
| NMR | |
| 構造・形状 | TEM |
| SEM | |
| AFM、STM | |
| TEMトモグラフィ | |
| 欠陥・結晶性 | PL、CL |
| Raman | |
| TEM | |
| X線回折 | |
| DLTS | |
| キャリア濃度 | SCM、SSRM |
| SR | |
| FT-IR | |
| ライフタイム | μ-PCD |
| 細孔径分布 | 小角X線散乱 |
| 陽電子消滅 | |
| TEM | |
| 分光エリプソメトリ |
| 評価項目 | 分析法 |
|---|---|
| 密着性 | 4点曲げ |
| ナノインデンテーション | |
| ラフネス | AFM、STM |
| TEM、SEM | |
| GIXR | |
| ボイド | TEM、SEM |
| 界面構造・状態 | TEM、SEM |
| AES | |
| XPS | |
| SIMS | |
| 異物・偏折 | TEM、SEM |
| AES | |
| Raman | |
| クラック | SEM、TEM |
| 膜厚・密度 | 分光エリプソメトリ |
| GIXR | |
| RBS | |
| エッチング残渣 | TDS、TPD-MS |
| SIMS | |
| EELS | |
| エッチングダメージ | FT-IR |
| EELS | |
| 不純物プロファイル | SIMS |
| 汚染 | ICP-MS |
| TOF-SIMS |